-
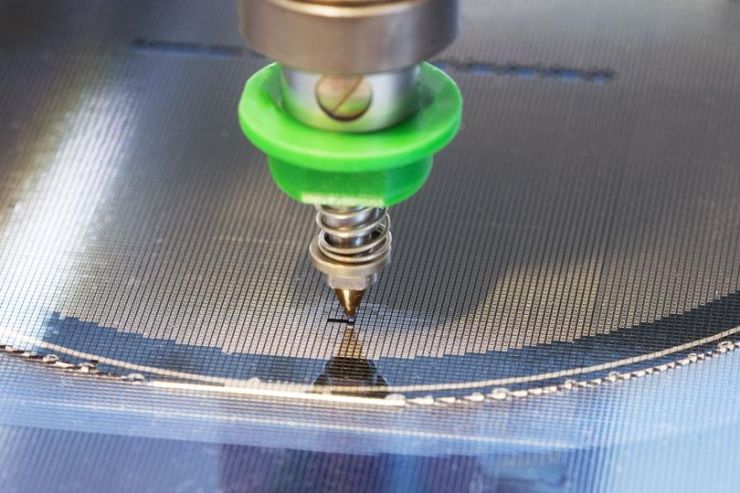
Die-Bonden
Infotech’s Lösungen für das Die-Bonden beschränken sich nicht nur auf das klassische Vereinzeln und Verpacken der Chips. Immer mehr werden andere Prozessschritte mit dem Die-Bonden kombiniert. Alle Die-Bonding Module aus der Komponentenmatrix lassen sich hervorragend mit Dosieren, Handhaben, Fügen, Montieren, Bestücken und weiteren Funktionen kombinieren, für die es sonst eigene Anlagen benötigt.
Wir verarbeiten Wafergrössen von 4" bis 12" auf unterschiedlichen Rahmenformaten. Die grosse Flexibilität, die unsere Plattformen bieten, wird durch die eigene Applikations-Software VisualMachinesTM unterstützt. Die Funktionen lehnen sich an den SEMI-Standards an, können aber auch auf die Bedürfnisse der Kunden angepasst werden.
Unsere Die-Bonding Lösungen sind prädestiniert zum Aufbauen von LED Produkten, Sensoren, MEMS, VCSEL Dioden und Leistungshalbleiter. Die-Grössen ab 200 µm ab Wafer, Chip-on-Chip/Chip-on-Wafer Applikationen gehören zu unserem Leistungsumfang. -

Flip-Chip Bonden
Sample Video - Flip
Beim Flip-Chip Bonden wird in der Regel ein Chip in einem BGA (Ball Grid Array), bzw. einem µBGA Gehäuse direkt mit dem Substrat verbunden. Das Verfahren eignet sich vor allem für Bauelemente mit einer hohen Zahl von Anschlüssen. Diese sind in Form von kleinen Lotkugeln (Bumps) auf der Unterseite des Gehäuses angeordnet. Das BGA/mBGA wird zum Bestücken kopfüber der Maschine zugeführt und muss danach gewendet werden.
Voraussetzungen für ein erfolgreiches Flip-Chip Bonding sind eine Wendeeinheit (Flipper), höchst präzises Ausrichten der Lotkugeln auf die Bondpads sowie die Möglichkeit, Flussmittel mittels Dosieren oder Dippen aufzutragen. Für Kleinserien, Prototypenbau oder Nacharbeit empfiehlt sich der Einsatz unseres bewährten Heissgas-Lötsystems.
Mit den Anlagen von Infotech lässt sich das Flip-Chip Bonden zuverlässig und professionell ausführen und allenfalls mit anderen hochwertigen Prozessschritten kombinieren. -
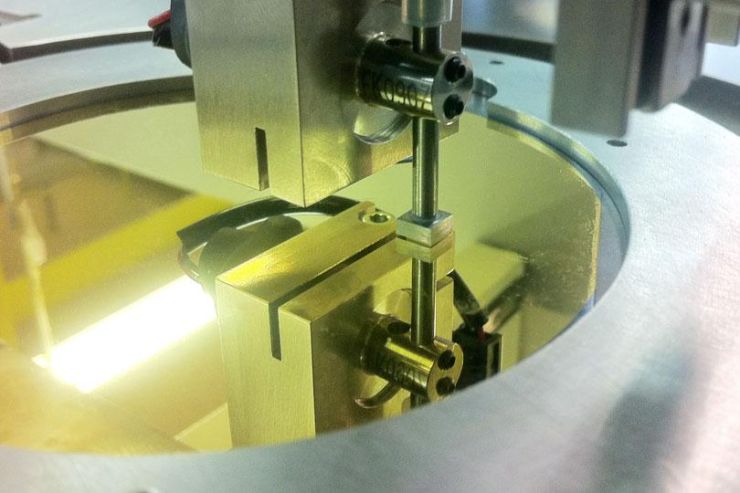
Ultraschallbonden
Das Ultraschall-Bonden oder auch "Thermosonic-Bonden" ist eine weitere Verbindungstechnik für das Aufbringen von "Bumped components" oder Flip-Chip Bauteilen direkt auf das Substrat. Dabei wird das Substrat festgehalten und vorgeheizt. Beim Absetzten des Flip-Chips wird das Bauteil über den durch Ultraschall angeregten Bestückungssauger vibriert und mittels kontrollierter Kraft auf das Substrat angepresst. Durch die Reibung der Bumps auf den Pads generierte Wärme, entstehen lokale, mechanisch feste Schweissverbindungen. Voraussetzung bei diesem Verbindungsprozess sind ein stabiler Aufbau der Anlage und das Zusammenspiel der Prozessparameter, welche kontrolliert und synchronisiert werden müssen. Das sind Substrattemperatur, Ultraschallleistung, Bondkraft pro Verbindungspunkt und die Prozesszeit.
Mit den Anlagen von Infotech lässt sich das Ulraschall-Bonden zuverlässig und professionell ausführen und allenfalls mit anderen hochwertigen Prozessschritten kombinieren. -
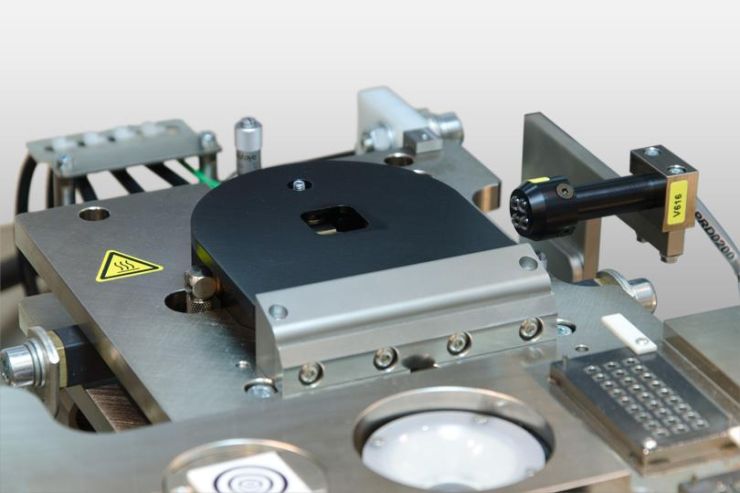
Eutektisch Bonden
Das Prinzip des Eutektischen Bondens erlebt seit dem Aufschwung der Glasfasernetze eine Wiedergeburt. Dieses schon lange bekannte Verbindungsverfahren beruht auf eutektischen Legierungen (Au-Sn, Si-Au oder Ge-Al), die bereits auf den Chip und den Träger aufgedampft wurden. Während des Bondens schmelzen die Metallisierungsschichten unter präzise kontrollierter Kraft und Temperatur ohne Hilfe von Flussmitteln auf. Der Chip wrid somit dauerhaft mit dem Substrat verbunden.
Die Anwendungen liegen häufig bei der präzisen Montage von VCSEL Dioden auf ihre Submounts. Dabei muss der Bonder nicht nur die exakte Lage kontrollieren. Vor allem gilt es, ein nur wenige Mikrometer grosser Überhang der emittierenden Kante und die Planparallelität zwischen Diode und Träger einzuhalten. Aber auch bei Verpacken von MEMS, bei Chip-on-Wafer Technologien und anderen auf Wafer basierten Bauteilen kommt das Eutektische Bonden zum Einsatz. -

Uhrenteile
Sample Video - Uhrenteile bestücken
Die automatisierte Montage von Uhrwerken, Zifferblättern und anderen Bestandteilen von Armbanduhren basiert klassisch auf halbautomatischen Maschinen oder auf Sonderanlagen.
Als weltweit erstes Unternehmen hat Infotech es geschafft, zusammen mit einem namhaften Schweizer Uhrenhersteller ein mechanisches Uhrwerk vollautomatisch zusammenzubauen.
Das Erfolgsrezept dafür heisst „Infotech Komponentenmatrix“, aus der standardisierte Achsen, Maschinenkomponenten und Zu-/Wegführsysteme stammen. Bei der Montage von komplexen Uhrteilen wie Zahnräder, Anker, Unruh setzen wir konsequent auf den Einsatz der Bildverarbeitung.
Es müssen nicht immer komplexe Montageprozesse sein. Auch das Bestücken von Zifferblättern, das Kleben und Montieren der Uhrgläser und viele weitere Anwendungen gehören zu unserem Repertoire.
-
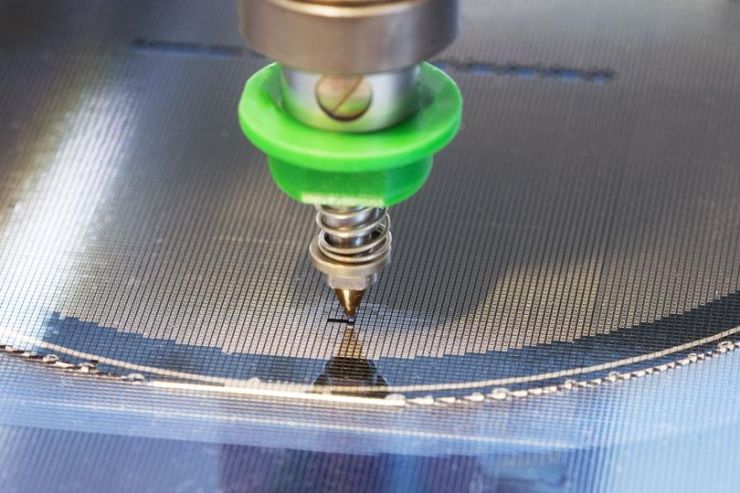
Die-Bonden
Infotech’s Lösungen für das Die-Bonden beschränken sich nicht nur auf das klassische Vereinzeln und Verpacken der Chips. Immer mehr werden andere Prozessschritte mit dem Die-Bonden kombiniert. Alle Die-Bonding Module aus der Komponentenmatrix lassen sich hervorragend mit Dosieren, Handhaben, Fügen, Montieren, Bestücken und weiteren Funktionen kombinieren, für die es sonst eigene Anlagen benötigt.
Wir verarbeiten Wafergrössen von 4" bis 12" auf unterschiedlichen Rahmenformaten. Die grosse Flexibilität, die unsere Plattformen bieten, wird durch die eigene Applikations-Software VisualMachinesTM unterstützt. Die Funktionen lehnen sich an den SEMI-Standards an, können aber auch auf die Bedürfnisse der Kunden angepasst werden.
Unsere Die-Bonding Lösungen sind prädestiniert zum Aufbauen von LED Produkten, Sensoren, MEMS, VCSEL Dioden und Leistungshalbleiter. Die-Grössen ab 200 µm ab Wafer, Chip-on-Chip/Chip-on-Wafer Applikationen gehören zu unserem Leistungsumfang. -

Flip-Chip Bonden
Sample Video - Flip
Beim Flip-Chip Bonden wird in der Regel ein Chip in einem BGA (Ball Grid Array), bzw. einem µBGA Gehäuse direkt mit dem Substrat verbunden. Das Verfahren eignet sich vor allem für Bauelemente mit einer hohen Zahl von Anschlüssen. Diese sind in Form von kleinen Lotkugeln (Bumps) auf der Unterseite des Gehäuses angeordnet. Das BGA/mBGA wird zum Bestücken kopfüber der Maschine zugeführt und muss danach gewendet werden.
Voraussetzungen für ein erfolgreiches Flip-Chip Bonding sind eine Wendeeinheit (Flipper), höchst präzises Ausrichten der Lotkugeln auf die Bondpads sowie die Möglichkeit, Flussmittel mittels Dosieren oder Dippen aufzutragen. Für Kleinserien, Prototypenbau oder Nacharbeit empfiehlt sich der Einsatz unseres bewährten Heissgas-Lötsystems.
Mit den Anlagen von Infotech lässt sich das Flip-Chip Bonden zuverlässig und professionell ausführen und allenfalls mit anderen hochwertigen Prozessschritten kombinieren. -
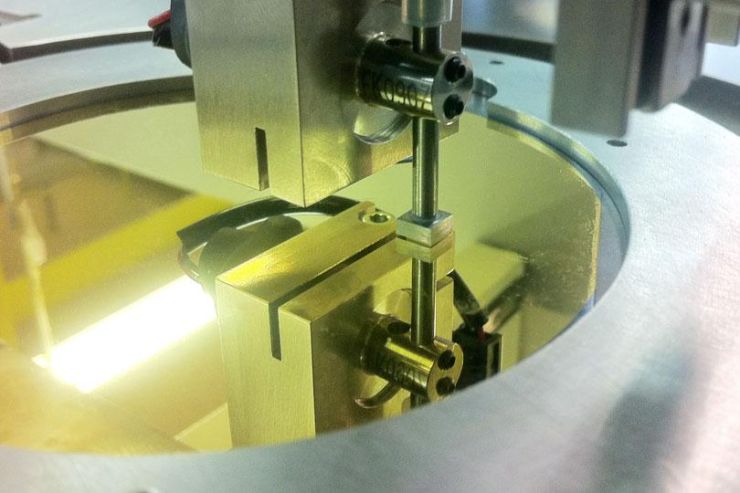
Ultraschallbonden
Das Ultraschall-Bonden oder auch "Thermosonic-Bonden" ist eine weitere Verbindungstechnik für das Aufbringen von "Bumped components" oder Flip-Chip Bauteilen direkt auf das Substrat. Dabei wird das Substrat festgehalten und vorgeheizt. Beim Absetzten des Flip-Chips wird das Bauteil über den durch Ultraschall angeregten Bestückungssauger vibriert und mittels kontrollierter Kraft auf das Substrat angepresst. Durch die Reibung der Bumps auf den Pads generierte Wärme, entstehen lokale, mechanisch feste Schweissverbindungen. Voraussetzung bei diesem Verbindungsprozess sind ein stabiler Aufbau der Anlage und das Zusammenspiel der Prozessparameter, welche kontrolliert und synchronisiert werden müssen. Das sind Substrattemperatur, Ultraschallleistung, Bondkraft pro Verbindungspunkt und die Prozesszeit.
Mit den Anlagen von Infotech lässt sich das Ulraschall-Bonden zuverlässig und professionell ausführen und allenfalls mit anderen hochwertigen Prozessschritten kombinieren. -
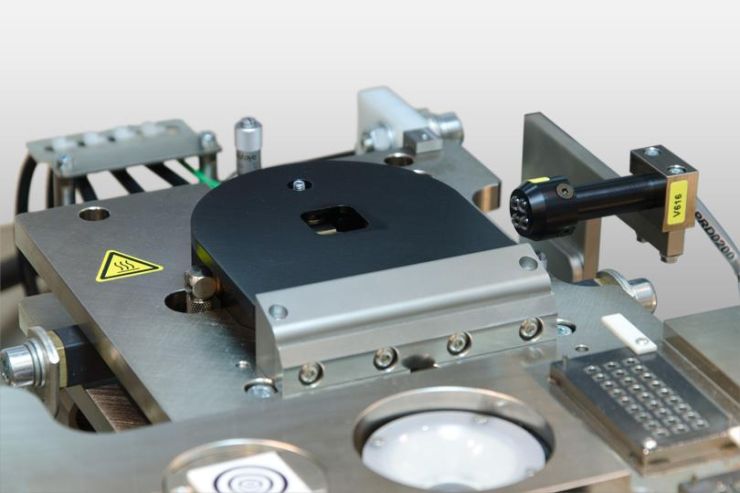
Eutektisch Bonden
Das Prinzip des Eutektischen Bondens erlebt seit dem Aufschwung der Glasfasernetze eine Wiedergeburt. Dieses schon lange bekannte Verbindungsverfahren beruht auf eutektischen Legierungen (Au-Sn, Si-Au oder Ge-Al), die bereits auf den Chip und den Träger aufgedampft wurden. Während des Bondens schmelzen die Metallisierungsschichten unter präzise kontrollierter Kraft und Temperatur ohne Hilfe von Flussmitteln auf. Der Chip wrid somit dauerhaft mit dem Substrat verbunden.
Die Anwendungen liegen häufig bei der präzisen Montage von VCSEL Dioden auf ihre Submounts. Dabei muss der Bonder nicht nur die exakte Lage kontrollieren. Vor allem gilt es, ein nur wenige Mikrometer grosser Überhang der emittierenden Kante und die Planparallelität zwischen Diode und Träger einzuhalten. Aber auch bei Verpacken von MEMS, bei Chip-on-Wafer Technologien und anderen auf Wafer basierten Bauteilen kommt das Eutektische Bonden zum Einsatz. -

Uhrenteile
Sample Video - Uhrenteile bestücken
Die automatisierte Montage von Uhrwerken, Zifferblättern und anderen Bestandteilen von Armbanduhren basiert klassisch auf halbautomatischen Maschinen oder auf Sonderanlagen.
Als weltweit erstes Unternehmen hat Infotech es geschafft, zusammen mit einem namhaften Schweizer Uhrenhersteller ein mechanisches Uhrwerk vollautomatisch zusammenzubauen.
Das Erfolgsrezept dafür heisst „Infotech Komponentenmatrix“, aus der standardisierte Achsen, Maschinenkomponenten und Zu-/Wegführsysteme stammen. Bei der Montage von komplexen Uhrteilen wie Zahnräder, Anker, Unruh setzen wir konsequent auf den Einsatz der Bildverarbeitung.
Es müssen nicht immer komplexe Montageprozesse sein. Auch das Bestücken von Zifferblättern, das Kleben und Montieren der Uhrgläser und viele weitere Anwendungen gehören zu unserem Repertoire.